
그림 1. 반도체 단면 SEM(주사전자현미경) 이미지
지난 10월 삼성전자는 14nm(나노미터, 1nm = 1×10-9m) 선폭1의 메모리 반도체 양산을 시작했습니다. 또한 현재 우리가 사용하는 컴퓨터의 CPU나 모바일 기기의 AP 등과 같은 시스템 반도체의 선폭은 5nm까지 줄어들었고, 세계 여러 기업들은 3nm 선폭의 반도체 생산을 위해 연구에 박차를 가하고 있습니다. 이렇듯 여러 기업이 반도체의 선폭을 줄이는데 혈안이 되어있는 상황에서 최근 가장 뜨거운 기술이 있는데요, 바로 네덜란드의 ASML사에서 개발한 13.5nm 파장의 EUV(Extreme Ultraviolet, 극자외선) 노광기술입니다. 이번 기사에서는 노광공정이 무엇이고, 이 노광공정에 EUV를 사용하는 것이 어떻게 반도체의 선폭을 줄이는지에 대해 알아보겠습니다!
노광공정이란?
‘노광공정(Photolithography)’은 웨이퍼2 위에 원하는 반도체를 제작하기 위해 회로 패턴을 그려 넣는 공정입니다. 이때 패턴을 그려 넣는 데 사용하는 ‘붓’으로 빛을 사용하기 때문에 ‘포토(Photo)공정’이라고도 합니다.

그림 2. 노광공정 모식도
노광공정에서는 빛에 반응하여 약해지거나(Positive) 단단해지는(Negative) 물성을 가진 감광액(Photoresist)을 사용합니다. 이 감광액을 웨이퍼 위에 고르게 펴 바르고, 원하는 회로 패턴이 담긴 마스크3를 씌운 상태에서 빛을 통과시키면, 웨이퍼에서 마스크로 가려지지 않은 부분만 빛에 반응하게 되어 회로가 웨이퍼에 그려지게 됩니다. [그림 1]처럼 빛과 감광액을 이용해 웨이퍼 위에 그림을 그리는 것이죠.
파장의 길이가 짧아야 하는 이유는?
그렇다면 이 노광공정에서 회로를 그릴 때, 더 촘촘하게 그려 선폭을 낮추려면 어떻게 해야 할까요? 우선 해상력과 분해능의 개념에 대해 이해해야 하는데요, 해상력이란 서로 떨어져 있는 두 물체를 구별할 수 있는 능력을 의미합니다. 분해능은 가장 좋은 조건 하의 해상력인데요, 예를 들어 분해능은 100nm지만, 주변이 어둡거나 기타 다른 상황으로 200nm 미만의 거리를 둔 물체를 인식할 수 없다면 해상력은 200nm인 것입니다. 더 낮은 해상력은 반도체 위의 더 좁은 회로를 구분할 수 있음을 의미하고, 따라서 해상력이 낮을수록 더 좁은 선폭의 회로를 그릴 수 있습니다. 그렇다면, 어떻게 해상력을 향상시킬 수 있을까요? ‘레일리의 식(Rayleigh’s equation) ’4은 노광공정에서 사용하는 빛의 파장이 해상력을 낮추는 열쇠임을 보여줍니다.
분해능 R을 줄이기 위해서는, 공정계수 k1은 작아져야 하고, 렌즈수차5 NA는 커져 빛을 더 잘 모아야 하며, 파장은 짧아져야 합니다. 즉, 공정계수와 렌즈수차가 일정하다면, 노광공정에서 파장이 짧은 빛을 이용할수록 회절의 효과는 줄어들어 더 정밀한 회로를 웨이퍼 기판 위에 그리는 것이 가능하다는 뜻이죠. 붓이 얇을수록, 더 얇은 선을 그릴 수 있겠죠?
-

그림 3. 분해능 모식도, 분해능보다 두 물체의 거리가 가까워지면 구분할 수 없다.
-

그림 4. 파장에 따른 회절
이 원리를 따라 노광공정에 사용하는 빛의 파장은 꾸준히 짧아져 왔습니다. 그 결과 시간이 갈수록 더 좁은 선폭의 반도체를 만들 수 있게 되었고, 이는 하나의 웨이퍼에 더 많은 반도체를 집적할 수 있게 되어 경제적인 이점을 가져다주었죠. 또한 반도체가 작아질수록 소모하는 전력이 감소하는 등 기능적인 측면에서도 반도체의 소형화는 많은 장점을 가집니다.
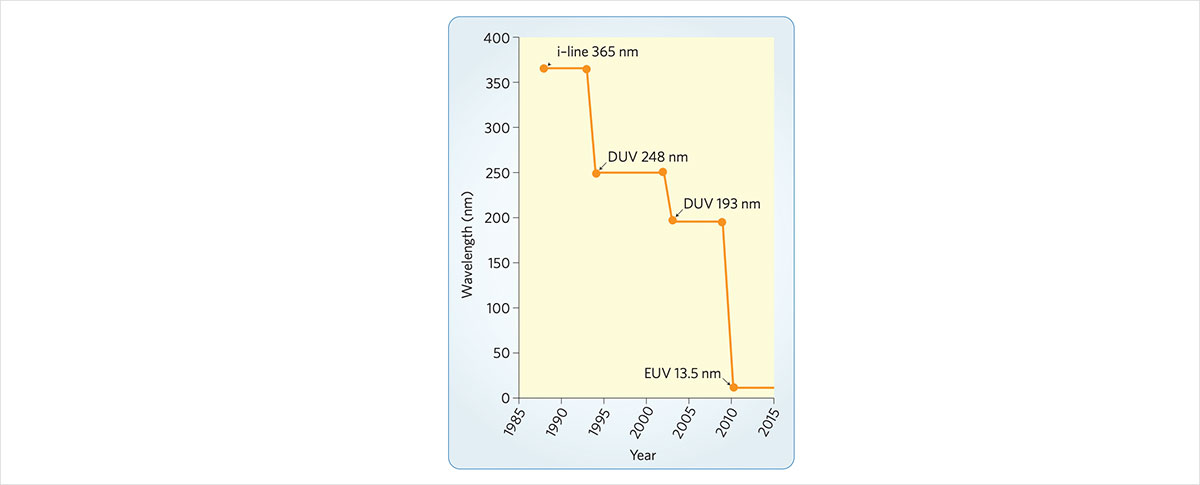
그림 5. 노광공정에 사용하는 광원의 파장 변화
하지만 노광공정에 사용하는 빛의 파장을 줄이는 것은 말처럼 쉬운 일은 아닙니다. 파장이 짧아질수록 빛을 얻어내는 것부터 어렵고, 주위 물질에 쉽게 흡수되는 문제점이 있기 때문인데요. 그러나 ASML사는 10년이 넘는 연구 끝에, 13.5nm의 매우 짧은 파장의 빛을 사용하는 EUV 노광장비 상용화에 성공하였고, 반도체 생산 기업들은 서로 먼저 장비를 갖추기 위해 고군분투하고 있습니다. 그렇다면, ASML사의 EUV 노광장비는 어떤 원리로 그간의 어려움을 극복할 수 있었던 걸까요?
EUV를 어떻게 얻어낼까?
EUV 노광공정을 위한 첫 번째 단계는 EUV를 만들어내는 것부터 시작합니다. ASML의 노광 장비는 LPP(Laser Produced Plasma) 방식으로 광원을 얻는데요, 바로 레이저를 통해 플라스마를 생성해 EUV를 얻어내는 기술입니다. 플라스마는 높은 에너지를 받아 이온화된 가스 덩어리로, 기체가 이온화되는 과정에서 전자는 들뜬 상태가 되어 높은 에너지 준위를 갖게 됩니다. 들뜬 상태의 전자는 다시 낮은 에너지 준위로 돌아가면서 전자기파를 방출하는데, LPP는 이 원리를 이용해서 EUV 광원을 얻습니다. ASML사의 EUV 노광장비는 CO₂레이저를 이용해 주석(Sn) 방울을 명중시켜 평평한 원판 모양을 만든 후, 다시 한번 맞춰서 플라스마 상태로 만듭니다. 이후 앞서 말한 원리로 플라스마에서 방출되는 EUV를 노광공정에 사용하는 것이죠. 이때 주석 방울은 초당 50,000회 떨어지는데, 이를 구현하기 위해서 굉장히 정밀한 기술이 요구됩니다.
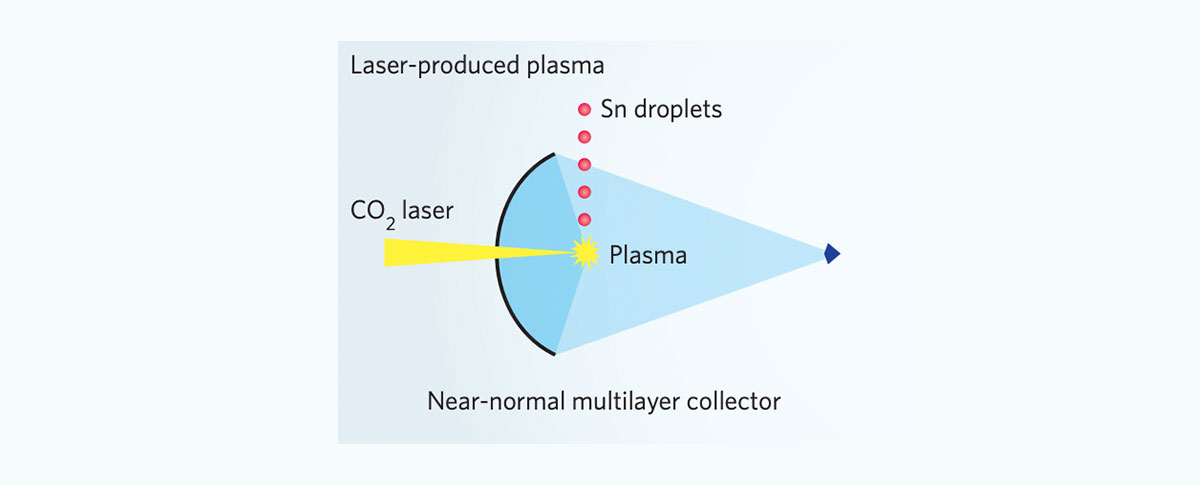
그림 6. LPP방식 모식도
EUV를 웨이퍼에 어떻게 노광할까?
LPP를 통해 얻은 EUV 광원을 웨이퍼 표면에 주사하기 위해서는 마스크의 크기에 맞게 모아주어야 합니다. 기존 노광공정에서는 이를 위해 렌즈를 사용했지만, EUV는 렌즈에 쉽게 흡수되기 때문에 렌즈 대신 여러 개의 거울을 사용합니다. 따라서 마스크에서도 기존 노광공정과 달리 빛이 반사하게 됩니다. 마스크에 정확하게 빛을 반사시켜야 웨이퍼 표면에 정확한 패턴을 그려 넣을 수 있으므로 반사 광학계의 정확도가 무엇보다 중요하겠죠? 그런데 노광장비 내부 입자에 의해서 광학계가 오염되면 반사율 손실이 일어나 노광 정확도에 문제가 발생하게 됩니다. 따라서 ASML사의 노광장비 내부는 EUV의 흡수를 줄이고 광학계의 정확도를 유지하기 위해 진공상태로 유지됩니다. 구체적으로는, EUV 노광장비의 진공 챔버(Chamber) 내의 주 잔류 가스는 수분(H₂O)과 탄화수소인데, 수분의 내부 압력은 대기압의 10,00,000,000분의 1(10⁻¹⁰)이고, 탄화수소의 내부 압력은 대기압의 1,000,000,000,000분의 1(10⁻¹²
)입니다. 이 덕분에 반사 광학계의 반사율 손실은 7~10년 동안 1% 미만으로 유지될 수 있습니다. 이처럼 ASML사는 반사율 손실률을 현저히 낮추어 EUV 장비의 상용화가 가능하게 했습니다.

그림 7. LPP방식으로 얻은 EUV가 반사 광학계를 통해 기판에 노광되는 과정
세상에서 가장 작은 그림, 반도체
1965년, 인텔의 공동 설립자 고든 무어(Gordon Earle Moor)는 24년마다 반도체 집적회로의 성능이 2배로 증가한다는 ‘무어의 법칙’을 제시했습니다. 하지만 2010년대로 접어들면서 더욱 미세한 선폭의 반도체 제작 공법 개발이 한계에 부딪히며 무어의 법칙이 한계에 다다랐다는 의견이 제기됐는데요, 다행히도 다른 여러 기술들, 무엇보다 EUV 노광기술이 등장하면서 무어의 법칙은 다시 연장되었습니다. 그리고 지금도 현재보다 더 작은 곳에, 더욱 정교한 회로를 그려 넣기 위한 공학자들의 노력은 계속되고 있어요. 대표적으로 레일리의 식에서 NA(렌즈수차) 값을 더욱 향상시킨 ‘High NA EUV’, 트랜지스터의 전류 제어 흐름을 획기적으로 증가시킨 ‘GAA(Gate All Around)’ 등 다양한 기술들이 개발되고 있답니다. 공상 독자 여러분도 공학도가 되어 세상에서 가장 작은 붓으로 세상에서 가장 작은 그림을 그리는 공학자의 꿈을 키워보세요!
1 반도체에서 회로와 회로 사이의 간격
2 반도체를 생산하는데 사용하는 기판
3 회로 패턴을 담은 필름
4 빛의 파장과 분해능의 관계를 표현한 식
5 점 광원에서 렌즈로 들어가는 빛의 각도
- 참고문헌
-
- Wagner, Christian, and Noreen Harned. "Lithography gets extreme." Nature Photonics 4.1 (2010): 24-26.
- Seisyan, R. P. "Nanolithography in microelectronics: A review." Technical Physics 56.8 (2011): 1061-1073.
- S주장헌. "EUV Lithography 를 위한 진공 기술." 진공이야기 1.3 (2014): 14-20.
- 정석균, and 전정범. "[총설] 주사전자현미경의 기본원리와 응용 (Part I)." Korean Industrial Chemistry News 12.6 (2009): 39-46.)
- Support Center for Microsystems Eudcation http://www.scme-nm.org
- ASML ‘Inside Everywhere’ http://insideeverywhere.co.kr/
- 두산백과 https://www.doopedia.co.kr/
- 그림출처
-
그림 1. https://www.thermofisher.com/
그림 2. Support Center for Microsystems Eudcation http://www.scme-nm.org
그림 3. 정석균, and 전정범. "[총설] 주사전자현미경의 기본원리와 응용 (Part I)." Korean Industrial Chemistry News 12.6 (2009): 39-46.
그림 4. 두산백과 https://www.doopedia.co.kr/
그림 5, 그림 6, 그림 7. Wagner, Christian, and Noreen Harned. "Lithography gets extreme." Nature Photonics 4.1 (2010): 24-26.



 그림 3. 분해능 모식도, 분해능보다 두 물체의 거리가 가까워지면 구분할 수 없다.
그림 3. 분해능 모식도, 분해능보다 두 물체의 거리가 가까워지면 구분할 수 없다. 그림 4. 파장에 따른 회절
그림 4. 파장에 따른 회절